ソシオネクスト、高エネルギー加速器研究機構(KEK)、京都大学(京大)、大阪大学(阪大)、J-PARCセンターの5者は7月16日、J-PARC 物質・生命科学実験施設 ミュオン科学実験施設の正負のミュオンビーム、京大 研究用原子炉の熱中性子ビーム、阪大 核物理研究センターの高エネルギー中性子ビームをそれぞれ半導体デバイスに照射することにより、ミュオンと中性子が引き起こすソフトエラー(保持データの反転)の特徴が異なることを実験的に明らかにしたと発表した。
同成果は、ソシオネクスト 信頼性技術部の加藤貴志氏、KEK 物質構造科学研究所 ミュオン科学研究系の反保元伸研究員(J-PARCセンター兼務)、同・竹下聡史助教(J-PARCセンター兼務)、京大 複合原子力科学研究所の田中浩基准教授、ソシオネクスト 信頼性技術部の松山英也氏、阪大大学院 情報科学研究科の橋本昌宜准教授、KEK 物質構造科学研究所 ミュオン科学研究系の三宅康博特別教授(J-PARCセンター兼務)らの共同研究チームによるもの。詳細は、IEEE系の核科学と工学の理論と応用を題材とした学術誌「IEEE Transactions on Nuclear Science」にオンライン掲載された。
半導体のプロセスの微細化に伴い、デバイス内の電子情報が環境放射線によって書き換わってしまう現象「ソフトエラー」が発生しやすくなることが知られている。冗長回路やエラー訂正回路などで対応可能だが、デジタル技術をより安全・安心なものとするため、環境放射線によるソフトエラーを適切に評価し、その影響を理解して対策することが求められている。
これまで、ソフトエラーを引き起こす環境放射線としては、宇宙線由来の中性子が最も問題視されていたが、近年の微細化の進展に合わせ、中性子に加え、同じく宇宙線由来の素粒子ミュオンによるソフトエラーも懸念されるようになってきた。ミュオンは中性子の3倍ほど多いとされ、問題になる可能性が指摘されているという。
しかし、ミュオンが引き起こすソフトエラーについての評価報告例は少なく、中性子が引き起こすソフトエラーとの違いがいなかったという。そのため、ミュオンと中性子の影響の総合的な評価が困難であったという。
こうした背景から研究チームは今回、宇宙線由来のミュオンと中性子それぞれが引き起こすソフトエラーの違いを理解するため、それらを半導体デバイスに照射する実験により、比較評価を実施することにしたという。
宇宙線由来のミュオンには正負の2種類があり、中性子に低エネルギーの熱中性子と高エネルギー中性子の2種類が知られている。今回の実験では、各研究機関の施設を活用することで、正負それぞれのミュオンビーム、高エネルギー中性子ビーム、熱中性子ビームを活用する形で環境放射線の影響に対する包括的な評価が行われた。
照射実験に用いられた半導体デバイスは、20nmプロセスで製造されたSRAMで、動作させた状態のSRAMに各量子ビームが照射され、各粒子が引き起こすSRAMのソフトエラーについて、エラー発生確率および複数ビットエラー発生の傾向が解析されたという。その結果、ソフトエラー発生確率・複数ビットエラー発生割合の電源電圧依存性および複数ビットエラーパターンの特徴について、ミュオンと中性子に明確な違いがあることが明らかになったという。
-
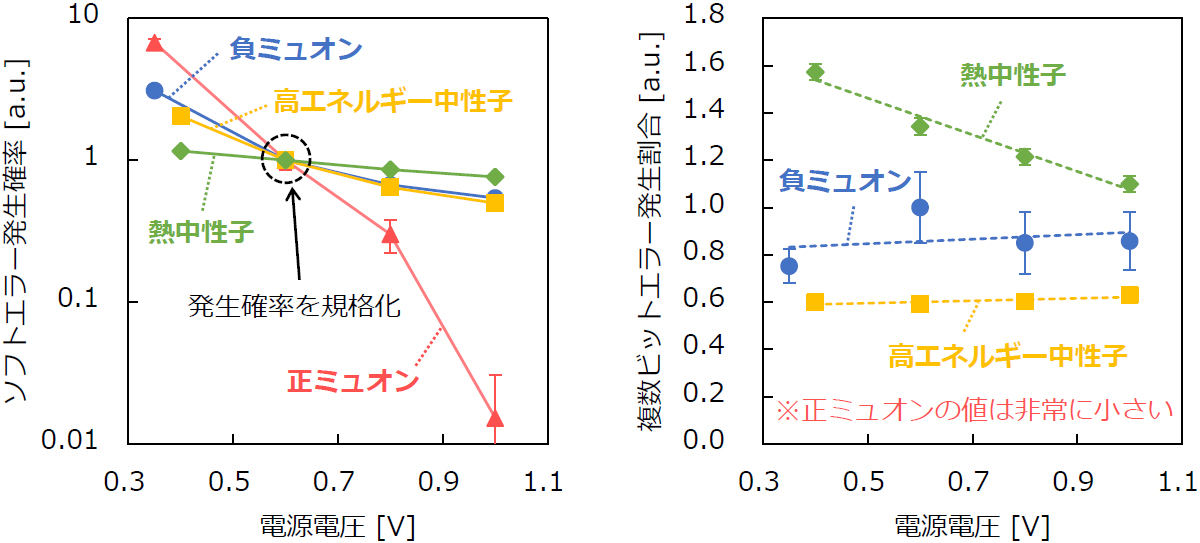
ソフトエラー発生確率(左)と複数ビットエラー発生割合(右)の電源電圧依存性。正ミュオンのソフトエラー発生確率は、中性子に比べて電源電圧依存性が急峻であることがわかる。また、負ミュオンの複数ビットエラー発生割合は、高エネルギー中性子と熱中性子の中間程度であることが見て取れる。なお、正/負ミュオンの実験は、ソフトエラー発生確率が最大となるエネルギー条件(ミュオンの照射効果の影響が大きい条件)で実施された (出所:ソシオネクストのプレスリリースPDF)
特に、負ミュオン特有の現象である、照射された先の物質の原子核に捕獲される反応によって起こされる「複数ビットエラー」は、中性子によって引き起こされるものとは異なる特徴が示されたとした。
中性子によって起こされるソフトエラーの原因には、熱中性子の捕獲反応や高エネルギー中性子の核破砕反応があり、これらでもソフトエラーが発生しやすくなるが、負ミュオンによるものはこれらとは異なる特徴を持つことが示されたとしている。
今回の成果を受けて研究チームは、ミュオンを含めた環境放射線に対する効果的なソフトエラー対策技術の開発につながるものだとしている。また、環境中のミュオンと中性子の割合は地域差があることが知られており、今回明らかになったミュオンと中性子の影響差は、半導体デバイスの使用場所を考慮した最適なソフトエラー対策設計につながるものだとしている。