2021年2月下旬にバーチャル形式で開催されたリソグラフィ技術に関する国際会議「SPIE Advanced Lithography Conference 2021」にて、ベルギーの独立系半導体研究機関であるimecと、露光装置メーカーのASMLは共同で、現在の最先端半導体製造ラインに導入されている開口数NA=0.33のEUV露光装置「NXE:3400」の性能を極限まで引き出したシングル露光パターニング機能を実証する2件の論文を発表した。
具体的には、プロセスの最適化により、大量生産を念頭に、Inpriaの金属酸化物レジスト(MOx)を使用して1回の露光で高密度の28nmピッチライン/スペースのパターン化が可能になった。
-
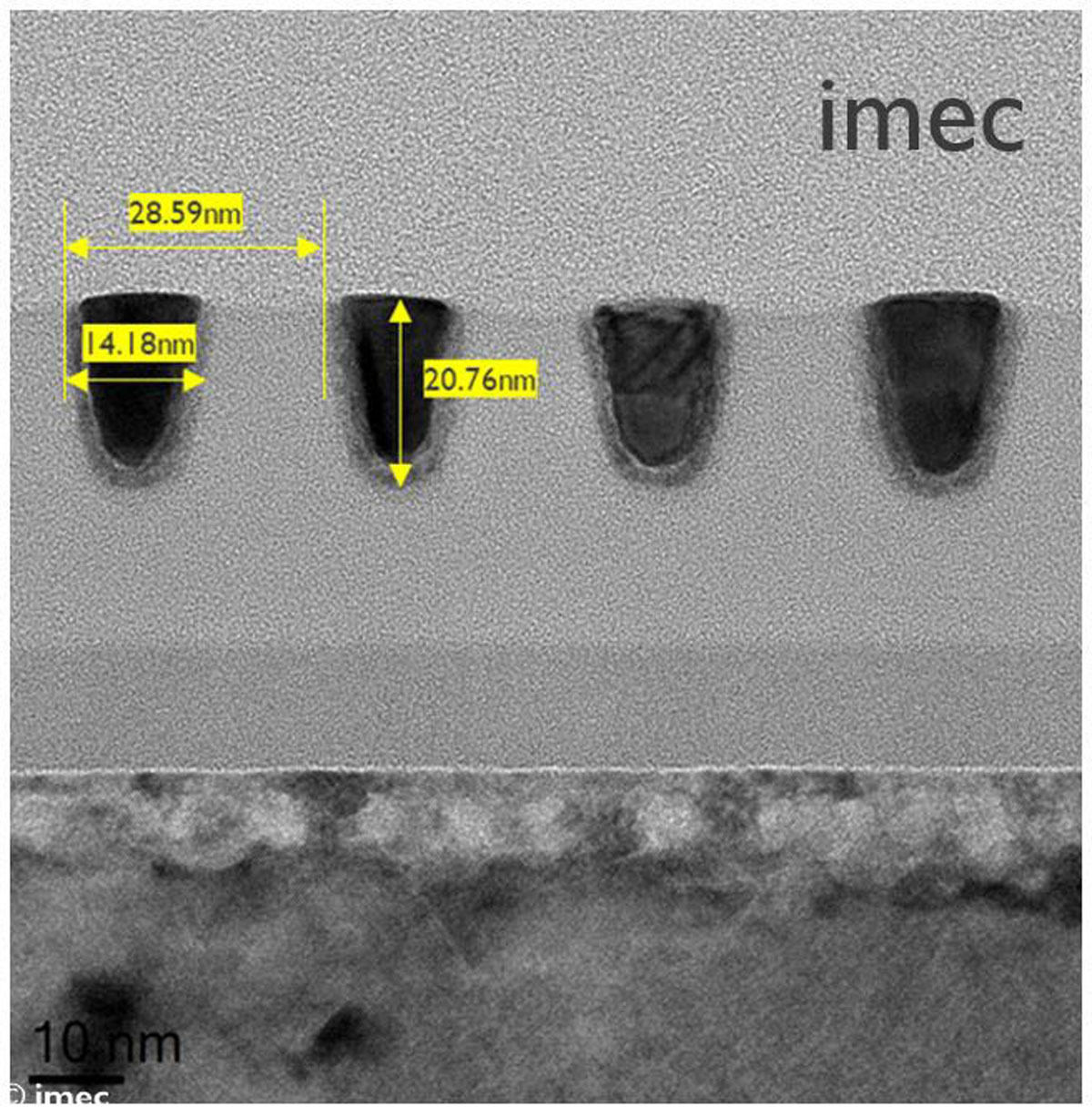
EUVリソグラフィのシングルパターニングにより形成した28nmピッチL/Sパターン。Ruメタル層形成後にNA=0.33の現行EUVフルフィールドスキャナでInpriaのMOxプロセスを使ってパターニングした28nmパターン (出所:imec)
この結果、光学的および電子ビーム検査を電気的データと相関させて、確率論的欠陥、つまり、欠損とブリッジの両方を改善するためのさらなる洞察を得ることができたという。また、光源の最適化により、NXE:3400で可能な限り最小のピッチ(子の場合、24nmピッチのライン/スペースと28nmピッチのコンタクトホール)を焼き付けることができるようになり、次世代の高NA EUV露光装置に必要な早期の材料開発が可能になったという。
EUVリソグラフィは、次世代ICの実現に向け、より高密度のパターンを焼き付けるためにマルチパターニング(多重露光)に移行するか、現行のNA=0.33のフルフィールドスキャナによるシングルパターニングをさらに改善するかの重要な分岐点に達しているとimecは指摘する。
imecの先進パターニングプログラムディレクターであるKurt Ronse氏は、「マルチパターニングに比べると、シングルパターニングは大幅なコスト優位性があり、はるかにシンプルなプロセスである。imecとASMLは、ライン/スペースに対して28nmピッチのシングル露光パターニングの準備ができていることを実証した。これは、5nmテクノロジーノードの重要なBEOL金属配線層に対応するものである。これは、NXE:3400スキャナの限界に近い性能である」と述べている。
また、imecの先進パターニングプロセスおよび材料開発担当VPのSteven Scheer氏は、「imecとASMLは、大量生産のためのシングル露光EUVLの限界を引き上げることに加えて、NA=0.33のNXE:3400の解像度を改善し、高NA EUVLツールの初期材料開発のプラットフォームとして適用することを目指している。imecのパターニングエコシステムとして、レジスト、計測、エッチングプロセスの開発につなげることで、次世代のEUVL、つまり高NAを実現したEXE:5000の導入を加速する機会が提供されるようになる」と今回の研究の意義を説明しているほか、今後は8nmピッチまでパターニングする高NAレジストイメージング機能の提供につながていきたいと今後の抱負を語っている。