Samsung Electronicsは8月13日、同社の製造受託部門であるSamsung FoundryのEUVリソグラフィを使用する微細化ロジックデバイス向けに独自の3D ICパッケージング技術「eXtended-Cube(X-Cube)」の提供を開始したと発表し、技術の詳細をHot Chips 32にて発表すると予告していた。
同社がHot Chips 32のポスターセッションで発表した際のタイトルは、「SAINT-S – 3D SRAM Stacking Solution Based on TSV Technology(SAINT-S:7nm TSV技術を用いた3D SRAM積層ソリューション)」で、SAINT-Sとは、「Samsung Advanced Interconnection Technology with SRAM」の頭文字を使った同社独自の造語である。
AIデバイスには、広いメモリ帯域幅とより大きなメモリ容量が必要であり、AR/VRデバイスには、可能な限り低いレイテンシも必要である。このため同社はTSV(貫通シリコンビア)を利用して今回、7nm CMOSロジックダイ(9.5mm×9.5mm)上に積層したSRAMダイ(9.0mm×9.0mm)を結線し、その間の高帯域幅と低レイテンシインタフェース、およびスモールフォームファクターを実現した。ちなみにロジックとSRAMを積層したパッケージサイズは12mm×12mmであったという。
-
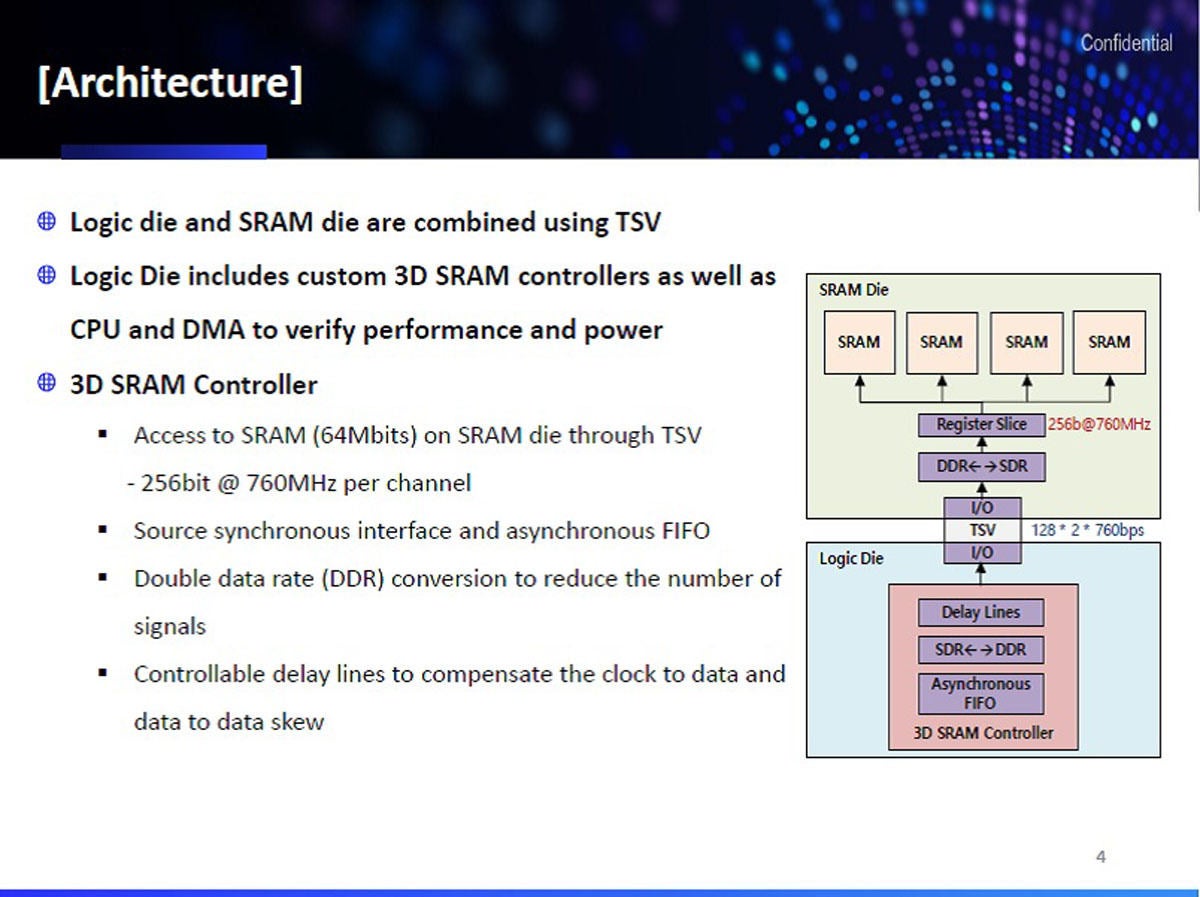
Samsung Advanced Interconnection Technology with SRAM(SAINT-S)の構成を示すダイアグラム (出所:Hot Chips 32のポスターセッションにおけるSamsungの発表資料、以下すべて)
実装結果では、7.2/2.6nsの読み取り/書き込みメモリレイテンシと24.3GB/sのメモリ帯域幅、760MHzの周波数でチャネルあたり0.156Wの平均消費電力を示した。
この結果、SAINT-Sの電力あたりのメモリ帯域幅は、GDDR6の6.2倍、HBM2eの2.2倍広くなったという。