キャリブレーション済みモデルを使用した複数ステップのアプローチ
imecの研究者たちは、BEOLの熱特性を評価するために、以下に説明するようなモジュール式のアプローチを採用している。そして、材料の熱特性をさまざまな次元スケールと詳細レベルで捉える、さまざまなタイプのモデルを開発してきた。各モデルは、関心のあるユースケースに応じて、単独で使用できるほか、そのアウトプットは次のモデルのインプットとしても使用できるため、BEOLスタック全体の完全な分析が可能になった。このようなモデリングとテストビークルを用いた実験で得られた測定データを組み合わせることで、正確なキャリブレーションと将来のシナリオの予測が可能になる。
3種類のサブモデルを段階的に適用
最初のステップでは、研究者たちは密度汎関数理論(density-functional theory:DFT)を使用して材料を原子レベルで調査する。DFTとは、電子エネルギーなどの物性を電子密度から計算することが可能であるとする理論で、これを使用して電子とフォノン、つまり材料内部のエネルギーを移動させる熱媒体の基本的な特性を導き出すことが可能となる。
次のステップでは、材料内の熱伝導がμmからnmスケールまでのさまざまな材料寸法に対してモデル化される。ボルツマン輸送方程式(BTE)に基づいたimecで開発したモデリングツールを使用する。このモデルは、熱効果をナノスケールで捕捉することが可能で、専用のテスト構造で特徴付けられた金属と誘電体の材料特性は、モデルの入力として使用される。例えば、誘電体の場合、いわゆる3ω(オメガ)法を使用して、関連する誘電体材料の熱伝導率を実験的に抽出する。その結果、SiO2では1.15W/mK、OSG3.0(低誘電率有機ケイ酸塩ガラス)では0.3W/mKという値が判明。ここでの3ω法とは、金属薄膜をヒーターおよび温度センサーとして共用することにより、広い周波数領域にわたって熱測定を可能にする方法である。
3番目のステップでは、BEOL構造の大部分を対象にすることとなる。このフルBEOLスタックの熱特性は、3D有限要素モデリング(FEM)アプローチを使用してモデル化され、自己発熱測定で校正されることとなる。この最終ステップでは、BEOLスタックとその個々の層の熱伝導率/抵抗マッピングが提供され、相互接続構造の温度上昇を迅速に評価できるようになる。
-
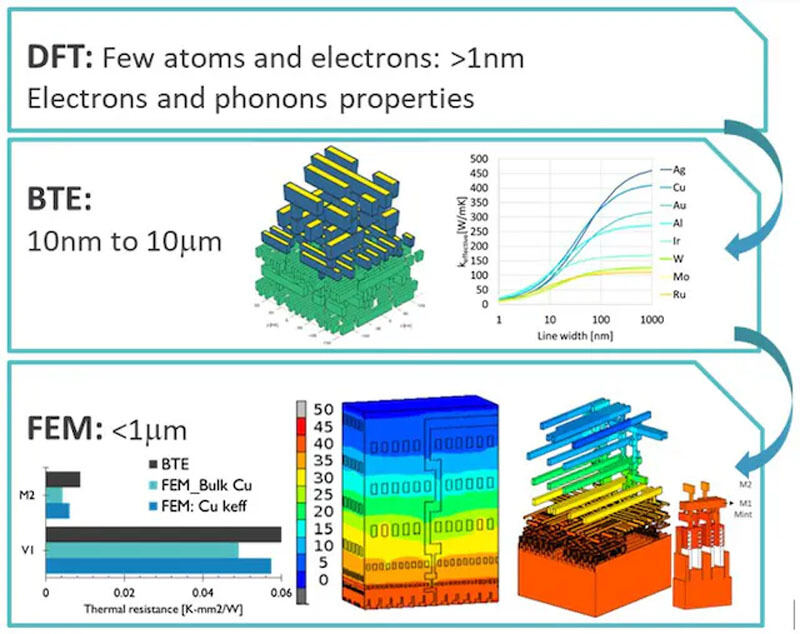
図1:imecの研究者たちが提案したハイブリッド熱モデリングアプローチの概略図。密度汎関数理論(DFT)、ボルツマン輸送方程式(BTE)、および有限要素モデリング(FEM)をベースにしており、さまざまな次元スケールで熱特性を捕捉できる (出所:imec)
BEOL内で熱がどのように伝播するかを完全に推定するには、モデルを用いてFEOLとBEOLの間の熱交換も考慮する必要がある。imecの研究者たちは、この熱交換を推定する方法も開発しており、追加の「層」としてFEMモデルに追加することを可能とした。
さまざまなユースケースにモデルに適用
金属単体の熱伝導率は線幅が10nm未満になると低下していく
BTEモデリング作業の典型的な結果として、「線幅の減少に伴う材料の熱伝導率の変化」が挙げられる。評価されたすべての元素金属では、線幅を10nmクラスにまで微細化すると熱伝導率が低下することが示された。これは、先端技術ノードの相互接続のローカルレベルに関連することも判明した。
low-k誘電体、ビア層および Myスタックが14層BEOLスタックの熱挙動と関連
マルチステップモデリングフレームワークを使用して、先端技術ノードの14層BEOLスタックの熱挙動を評価したところ、BEOLの設計および技術オプションが温度上昇にどのように影響するかについて興味深い示唆が得られた。
金属間誘電体の熱伝導率が1W/mKを下回ると、BEOLの急速な温度上昇が観察された。これは、OSG3.0など現在使用されているほとんどの誘電体材料の熱伝導率の範囲内であったが、A14(1.4nm)テクノロジーノード以降でエアギャップが導入されると、エアギャップの熱伝導率は低いことから影響がでてくることとなり、シミュレーションでは、金属配線の自己発熱が30%増加することが示された。逆に金属の場合、熱放散への影響は最小限となることも示された。
ビアの密度と構成の影響も無視できない問題となる。ビアの密度が大きいほど、相互接続層間の熱放散が促進されることがわかっている。同じことがスタックビア構成にも当てはまり、異なる層間のビアは適切に位置合わせされなければならない。このような構成は通常、電力供給に使用されるグローバル相互接続層(Mz)に適用される。MxおよびMy層での信号ルーティングに一般的に使用される、よりランダム化された構成は、相互接続層の発熱の増大をもたらすこととなる。
最後に、low-k材料がMy層の金属間誘電体として使用される場合、MyスタックがBEOLスタック全体の熱抵抗を支配することとなる。したがって、BEOLスタックのMyは、熱最適化の最も重要な機会を提供することとなる。この分析では、ビア層の影響も確認されている。14層スタックの場合、ビア層はBEOLスタックの総熱抵抗の86%に寄与しているが、配線層は14%しか寄与していないことが示された。なお、層の熱抵抗は、その厚さを熱伝導率で割ったものとして定義される。
-
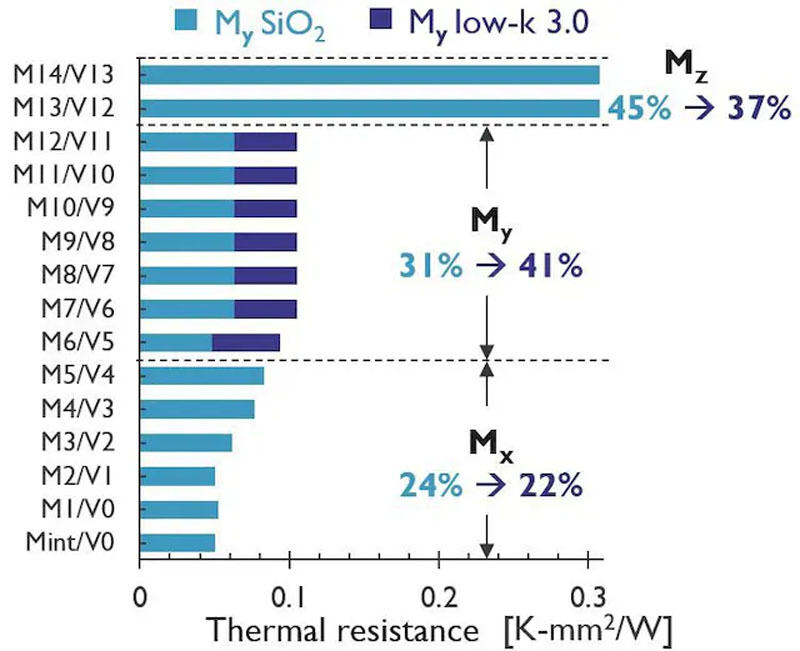
図5:各層の熱抵抗の寄与。すべての層で金属間誘電体としてSiO2を使用する場合、ビアの垂直方向の接続性が良好であるにもかかわらず、Mz層の厚さが厚いため、熱抵抗が最も高くなる。しかし、低誘電率3.0のlow-kをMy層の誘電体として適用すると、Myスタックがスタック全体の熱伝導率を支配することが示された (出所:imec)
FEOLとBEOL間の熱交換はパッケージと冷却ソリューションに依存
金属配線の温度は、BEOLスタック内の配線の自己発熱とFEOL内の発熱の組み合わせで決まる。FEOLとBEOLの間で交換される熱は、チップのパッケージング方法と、パッケージを冷却するために提供されるソリューション、つまりアプリケーションに大きく依存している。開発されたモデルでは、異なる冷却シナリオを持つ3つのフリップチップパッケージで評価が行われた。
最初のシナリオは、オーバーモールドされたフリップチップパッケージで、FEOLに最も近いパッケージの上部から自然対流によって冷却される。2番目のシナリオでは、上部への熱伝導を改善するために金属製の蓋フレームを追加。3番目のシナリオでは、上部に強制冷却を適用した。1番目と2番目のシナリオはモバイルアプリケーションなどに向けたもので、3番目の強制冷却は通常、HPC分野で使用されている。
-
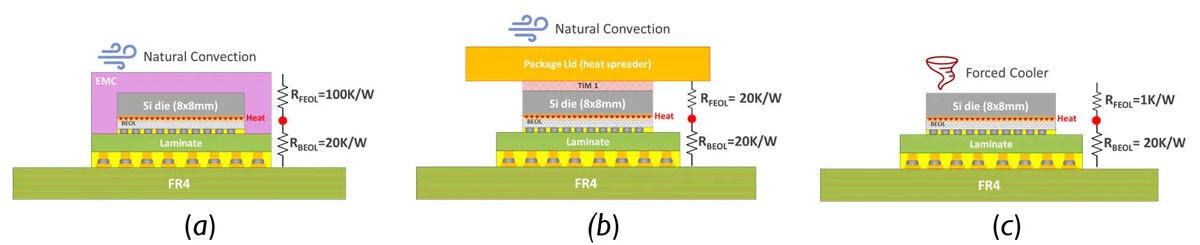
図6:3つのICパッケージオプション。(a)自然対流を備えたオーバーモールドパッケージ。(b)自然対流を備えた金属蓋フレームパッケージでオーバーモールドされたもの。(c)強制冷却によるベアダイパッケージ。実験による特性評価から得られた熱抵抗を追加 (出所:imec)
この中で1番目のシナリオでは、FEOLで生成された熱のほとんどがBEOLを介してフリップチップパッケージが取り付けられている積層板に向かって除去されます。言い換えれば、この冷却ソリューションは、FEOLとBEOLの自己発熱に対して大きな熱抵抗をもたらすこととなる。これが2番目と3番目のシナリオでは、上部に向かう熱経路が改善され、同じFEOL出力で温度がそれぞれ40%と90%低下するが、BEOLの自己発熱はわずかしか低下しないことも示された。
設計・プロセス技術同時最適化にとって貴重なツールとなるシミュレーションモデル
これまで説明したように、提示された各モデルは、対象となる次元スケールに応じて、特定のユースケースに適用できる。例えばFEMモデルを、単純化されたBEOLスタックに適用して、セミダマシンなどのより高度なメタライゼーションスキームの熱的側面をローカルレベルで調査することもできる。また、パッケージモデル内のさまざまなパッケージ構成を入力することで、代替の配線および電力供給スキーム(背面電力供給など)を評価することもできる。
最終的には、チップのBEOLにおける熱ボトルネックを軽減することで、対象のアプリケーションにシステムパフォーマンスの利点がもたらされることとなるため、今回の研究で提案されたシミュレーションモデルは、システムスケーリングの主要なボトルネックを解決できる適切なテクノロジー要素を特定するのに役立つと思われる。これらは、imecの3Dおよび設計とプロセステクノロジーの同時最適化(DTCO)作業、そして最終的にはシステム アプリケーションのニーズに起因するシステム・テクノロジーの協調最適化(STCO)に重要なインプットを提供するものとなることが期待される。
 |
Melina Lofrano
imecの熱モデリング開発チームの研究者。ブラジル・サンパウロ大学で機械工学分野の博士号取得後、2008年にimecに入社。さまざまな種類のデバイスの信頼性向上のための熱的および機械的分析に従事した後、現在は3Dシステム集積のための熱解析やナノプロセスオーダーのICに対する熱モデリングとその解析を行っている。 |
 |
Xinyue Chang
imecおよびルーベンカトリック大学(KUL)の研究者。熱モデリングと先進BEOLの実験解析を主に研究中。2019年に上海交通大学で電気通信工学分野の修士号を得たのち、imecに入社。ルーベンカトリック大学にも籍を置き博士号を目指して研究している。 |
 |
Herman Oprins
imecのサーマルモデリング研究開発チームリーダー。ベルギーのルーベンカトリック大学で機械工学分野の博士号取得。2003年にimec入社以来、サーマルモデリングとその様々なデバイスへの適用に従事。高度な半導体パッケージ、3Dシステム統合、Siフォトニクス、CMOSデバイススケーリング、BEOL相互接続、GaNパワートランジスタ、太陽光発電モジュール、マイクロ流体工学など、幅広い分野をカバーしている。 |
 |
Zsolt Tokei
imecフェロー兼相互配線分野のプログラムディレクター。1999年にimecに入社、CuのLow-K相互接続分野のプロセス研究者を経てナノインターコネクト(微細相互配線)のプログラムディレクターに就任。1994年にハンガリーのコシュート大学で物理学の博士号を取得した後、コシュート大学とフランスのエクス・マルセイユ第3大学の枠組みの中で、物理学と材料科学の博士号を1997年に取得。1998年にドイツのデュッセルドルフにあるマックスプランク研究所で博士研究員となり、imecに入社した後は、スケーリング、メタライゼーション、電気的特性評価、モジュールの統合、幅広い相互接続の問題に取り組んできた。 |