IntelがAMDのGPUを搭載する理由
Hot Chips 30においてIntelは、AMDの「Radeon RX Vega M GPU」を搭載した第8世代のCore CPUを発表した。
なぜIntelがライバルのAMDのGPUを使うのかであるが、次の図に示すように、プロセサ内蔵GPUを使えば消費電力も少ないが、ゲーマーなどの性能要求を満たせない。一方、外付けのGPUを使えば、性能は満足させられるが、消費電力が大きくバッテリ駆動には適さない。
高性能グラフィックスと電池駆動ができる低電力を両立させるためには、CPUと外付けグラフィックのチップをパッケージレベルで集積して、高性能、低電力を実現する必要があるという。
-

CPU内蔵GPUは性能が低い。外付けGPUは性能は高いが消費電力が大きくバッテリ駆動に適さない。高性能でバッテリでも使えるPCを実現するには、CPUと外付けGPUのチップをパッケージレベルで統合するのが解である (出典:このレポートのすべての図は、Hot Chips 30でのIntelのSrinivas Chennupaty氏の発表スライドのコピーである)
具体的には、Intelの第8世代のKaby LakeプロセサとAMDのRadeon RX Vega M GPUとGPUに接続する4GBのHBM2メモリの3チップを1つのパッケージに搭載する。
CPUはTDP 45Wのチップで、Vega GPUとHBM2メモリを加えると100Wを超えると思われるが、電力制御などでパッケージのTDPは65W/100Wに抑えている。
CPUは4コアで、ベースクロックが3.1GHzでターボ時には4.2GHzまでクロックアップできる。GLという製品とGHという製品があり、GLのRadeon RX Vega M GPUは20 Compute Unitでクロックは931MHzのチップを搭載し、GHは24 Compute Unitで1063MHzクロックのチップを使っている。GL製品のTDPは65W、GH製品は100Wである。
なお、AMDのハイエンドディスクリートGPUであるVega 64は64 Compute Unitであるので、これらのIntel製品に搭載されているGPUは、それに比べると1/3程度の規模である。
なお、このプロセサはCore i7-8809G、Core i7-8709G、Core i7-8706G、Core i7-8705G、Core i5-8305Gなどという型番ですでに販売されている。
CPUとGPUを1チップ化した際の課題
次の図のように、IntelはCore CPUの方にもIntel Gfx GPUがあり、1個のパッケージに2個のGPUがあることを強調しているが、どのようなケースでGfxの方を有効活用できるのかは示していない。
複数のチップをパッケージ上で集積する方法としては、次の図のように、パッケージ基板の配線で接続する方法が一般的であるが、この方法では高密度の接続はできない。図の2番目に描かれた方法は、シリコンインタポーザという配線だけを作り込んだシリコン基板で接続する方法で、高密度の接続ができるがコストが高い。
これに対してIntelは、EMIB(Embedded Multi-Die Interconnect Bridge)という技術を開発した。図の3番目に見られるように、チップ間の接続部分だけに小さなシリコン基板のブリッジ配線を作るという方法で、コストを安く抑えられる。
これでIntelのCore CPUとAMDのVega GPUとHBM2メモリを接続すれば良いのであるが、実際にやるとなると、CPUとGPUとHBM2それぞれの製造工場は異なっており、検査のやり方も違うし、物流のコントロールも必要。そして、チップの厚みが違っており、HBM2メモリはカスタムの研磨を行って厚みを合わせる必要が出たなど、いくつも問題が出たという。
消費電力のコントロール手法
そして、最適な消費電力管理を行うためには、IntelのDynamic Power Thermal Frameworkを拡張して、Vega GPUを含めた電力管理を行うことが必要になる。
次の図にみられるようにVega GPUとHBM2メモリの間はEMIBテクノロジを使い高密度の配線を実現している。一方、CPUとGPUの間の接続はx8のPCI Expressであり、本数がそれほど多くはないので、パッケージ基板のプリント配線で接続している。
CPUとGPUとGDDR5 DRAMをマザーボードに搭載して、プリント板の配線で接続した場合と比べると、この1個のパッケージに集積したシステムでは、マザーボードの面積を1900mm2節約でき、それだけノートPCのサイズを小さくできるし、消費電力も低減できる。
そして、CPUとGPUチップはチップの動作状況をIntel Dynamic Tuningというソフトウェアに通知し、それぞれのチップの電力コントロールポリシーのアップデートを受け取り、消費電力をコントロールする。
このようにダイナミックに必要な部分に電力を廻すコントロールを行なうことにより次の図に上げた3つのゲームではフレームレートを10%~20%向上できたという。
次の図はi7-8550U CPUにNVIDIAのGTX 1050 GPUを接続したシステムとRadeon Vega M GLグラフィックスを同一パッケージに搭載したi7-8705Gプロセサを使うシステムの性能を比較したものである。
文字がずれていて見難いが、最初の比較は3DMark 11-Graphics、その後が、Hitman、Deus Ex: Mankind Divided、Vermintide2の結果であり、Deus Exは1.1倍であるが、その他は1.3倍から1.4倍の性能となっている。
ただし、i7-8550Uはベースクロックが1.8GHzで、i7-8705Gに使われているベースクロック3.1GHzのCPUと比較するとかなり性能が低い。また、AMDのCUは64個の32bit積和演算器を持ち、20CUのi7-8705Gは1280個の32bit積和演算器を持っている。これに対して、NVIDIAのGTX 1050は768個である。ということで、公平な比較であるかどうかには疑問がある。
-
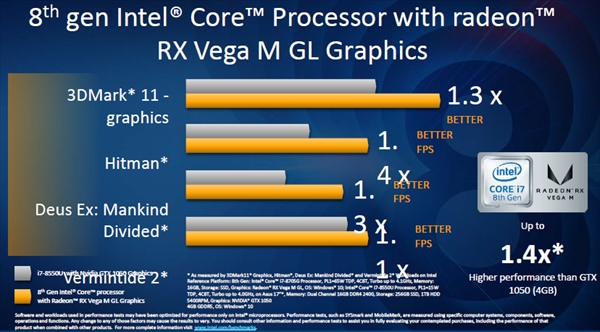
Vega GPUを同一パッケージに集積したシステムとi5-8550U CPUにNVIDIAのGTX 1050ディスクリートGPUを接続したシステムの性能比較。このシステムの方が1.1倍から1.4倍のフレームレートとなっている
結論であるが、パッケージングは興味深い新製品を作る重要なツールである。EMIBを使うとヘテロジニアスな製品を素早く作ることができる。
そして、プラットフォームレベルの熱/電力制御により性能を最大化できる。