ベルギーimecは、SPIE(国際光工学会)の年次国際会議「2023 Advanced Lithography + Patterning Conference」にて、先端プロセスにおけるリソグラフィ/パターニングの環境への影響に対する定量的評価結果を発表した。
imecは「imec.netzeroモデリングプラットフォーム」と呼ぶ仮想ファブを開発し、シミュレーション活用による環境影響評価を実施した。imecとパートナーは、得られた分析結果により、現在の製造上のリソグラフィ/パターニングの選択肢を評価し、重点分野を特定し、将来を予測することができるようになったという。
また、imecでは実際の300mmファブでも、環境影響が大きいカテゴリの環境負荷低減の検討も行われており、フッ素系エッチングガスの削減、EUVスキャナーのスループット最大化、水素と水の消費量の削減が含まれているという。
IC製造に関連するCO2排出量は、プロセスの複雑化とウェハ生産数の増加により、今後10年間で4倍になると予想されている。これを防ぐため主要な半導体企業は2030年から2050年までにカーボンニュートラルまたはネットゼロとすることを目指しており、imecも「持続可能な半導体技術とシステム(SSTS)」プログラムを立ち上げ、パートナーとチップ製造時のCO2排出ゼロを目指している。
imec.netzeroはこのSSTSプログラムの枠組みで開発されたモデリングプラットフォームで、さまざまなロジックノードのパターニング関連のプロセスステップの環境への影響を定量化することが可能となり、3nmプロセスでのリソグラフィとエッチングプロセスが、製造における所有または運用された資産からの排出量(スコープ1)、および購入したエネルギーからの排出量(スコープ2)の45%を占めることを確認したという。
-
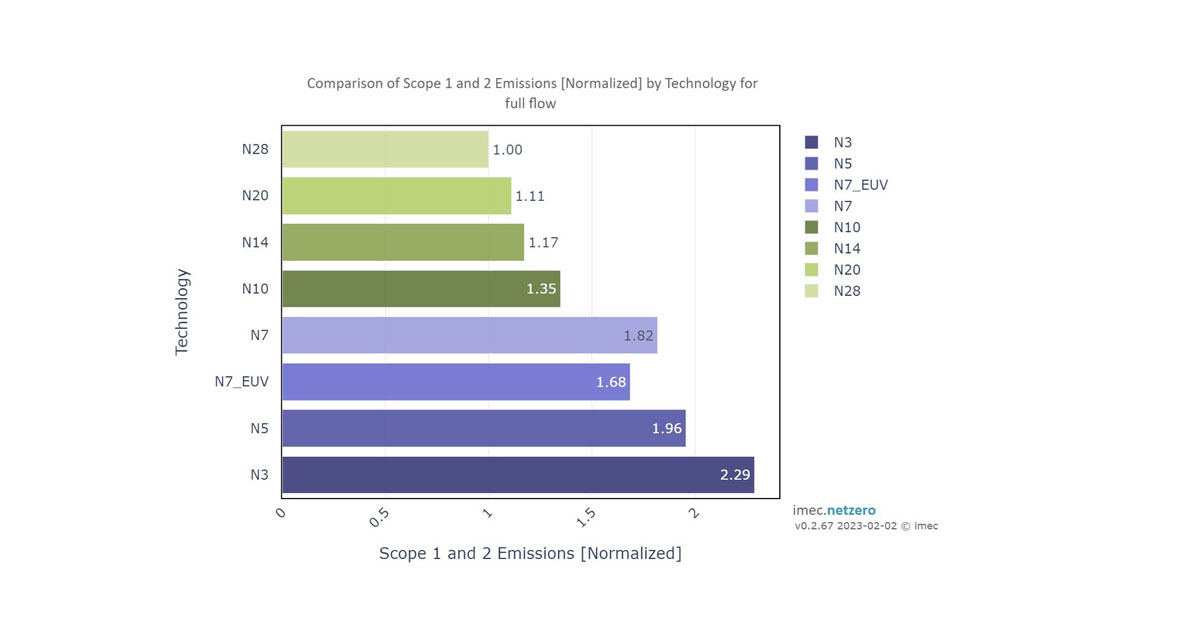
28nmから3nmに至るロジックデバイス製造のフルフロープロセスで発生するスコープ1および2放出量の相対的比較(28nmプロセスを1として比較。7nmは、ArF液浸マルチパターニングとEUV単一露光を比較) (出所:imec)
imecのリソグラフィ技術スタッフのEmily Gallagher氏は「7nmプロセスでEUVとArF液浸のマルチパターニングで比較すると、EUVの方がCO2排出量の点で有利であることが分かった」と述べている。また、「EUV照射量を10%下げると、ウェハ1枚あたり約0.4kgのCO2削減ができ、大規模なファブでは月あたり約40トンのCO2排出量削減ができるようになる」ともしている。
最近、imecは英Edwardsと協力して、300mmクリーンルームにEUV用水素回収システムを設置したという。また、NA=0.33およびNA=0.55 EUVの低照射量ソリューションによるリソグラフィコスト削減に注目しているほか、持続可能性の検討としてエッチングの課題を特定し、ガス消費量の全体的な削減に焦点を当てており、次のステップとしてこれらのソリューションが実際の半導体プロセスフローに与える影響の定量化を目指すとしている。
imecでは今回の取り組みを通じ、性能を維持しながらCO2排出量を削減する最初のマイルストーンに到達したとしており、シミュレーションを活用して取り組みを加速していくとしていく一方、環境への影響はCO2排出量削減だけでは不十分ともしており、半導体材料にPFAS(有機フッ素化合物)が含まれている可能性があるため、その排除手法などの検討も進めていく必要があるともしている。