EUVフォトレジストの課題克服にimecはどのように挑んでいるのか?
従来の多成分ブレンドフォトレジストシステムによって引き起こされる化学的確率論(つまり、ショットノイズ以外の確率論)から生じる懸念に対処するために、新しいレジスト材料が開発されている。例えば、金属含有レジストや単一成分レジストである。imecでは、材料サプライヤが新たなコンセプトを開発する際、汚染リスクやプロセス統合の課題などを評価できるようにしている。
新たな高NA EUVレジストは閉鎖的な研究環境では開発できず、最高のパフォーマンスを発揮するためには、適切に設計された下地層、新しいハードマスク、選択性の高いエッチングプロセスとの最適化が必要である。この課題に対処するために、imecは最近、レジストと下地層の特性を一致させる新しいツールボックスを開発した。
材料のスクリーニング、表面エネルギーマッチングの研究、材料の物理特性評価、および界面状態調査を行うことにより、スピンオンまたは堆積された下層膜をフォトレジストと一緒に開発することで、最適化されたLER、感度、および欠陥率を備えたEUVパターニングのスケーリングが可能になる。
さらに、材料開発を加速するためにEUV露光下でのレジストと下地層の両方の挙動についての洞察を得るためのツールボックスとして「Attolab」と呼ばれるパターニング材料特性評価インフラストラクチャを構築した。これにより放射測定と反射測定を用いて、薄膜とスタックの吸収係数と層構造特性を研究できるようになった。
-
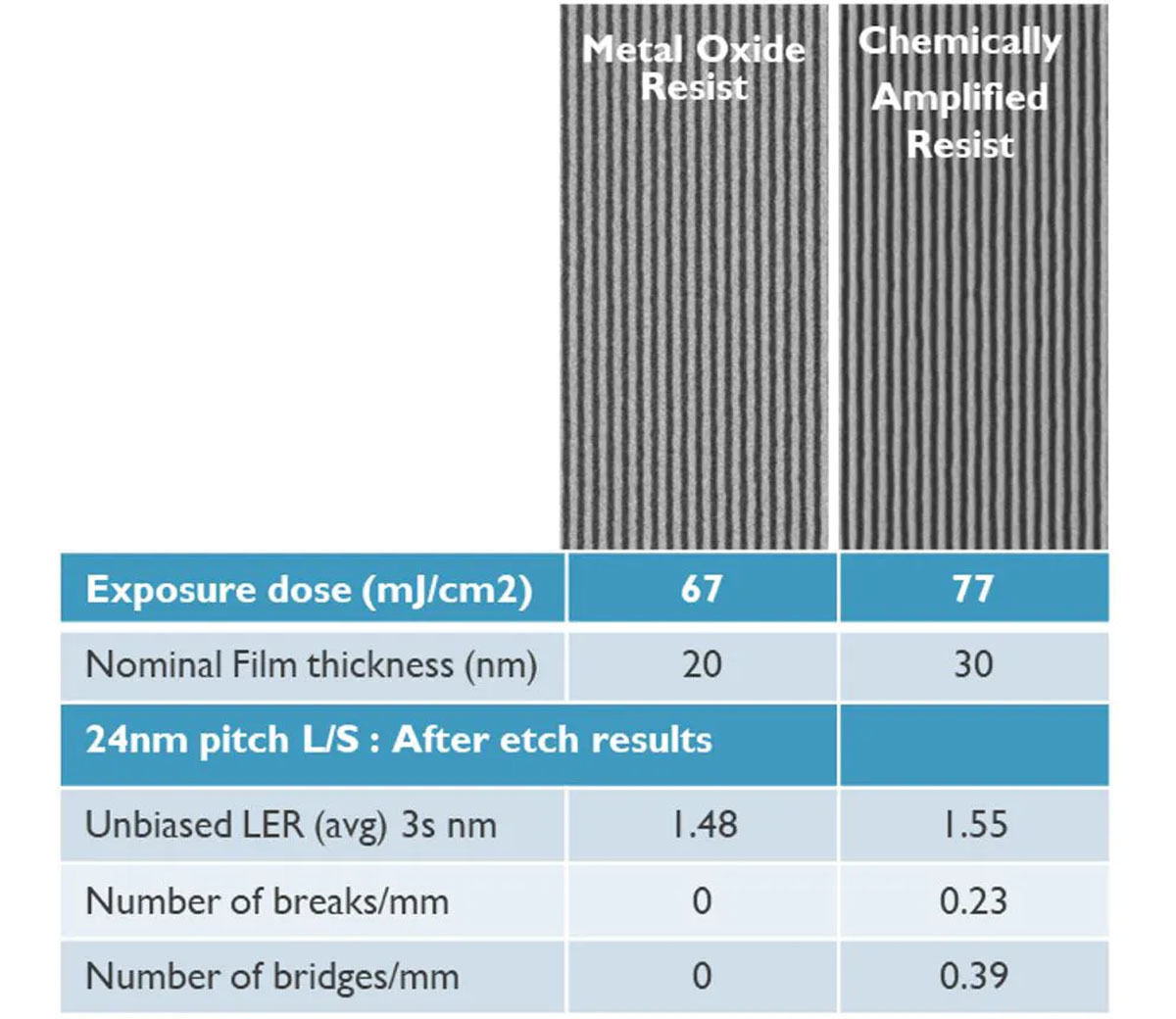
24nmピッチラインアンドスペース。金属酸化物レジスト(MOR)および化学増幅型レジスト(CAR)のパターニング開発。MORは、厚みが薄いにも関わらず、線量が低く、LERと欠陥率が優れていることを示している (出所:imec)
次世代の微細化の実現に向けた新手法を模索
フォトマスクに関しては、いくつかの新しい試みが進められている。例えばEUVの露光量を下げるという要件に対しては、low-n吸収体を使用したマスクが研究されている。これは、低露光量で高コントラスト(またはNormalized Image Log Slope:NILS)の空間強度プロファイルを作成することを目的にしている。
imecでは、ウェハの確率論的欠陥とマスクの3D効果(マスクの3Dトポグラフィに関連する空間像の歪み)についても懸念している。ウェハレベルでの確率的欠陥は、マスクのばらつきが原因の1つだが、他に多くの原因がある。この問題に対処するために、新たにマスクとブランクの仕様を提案することを目的として、どのタイプのマスク変動性(さまざまなラフネスを含む)がウェハレベルで確率論的欠陥を増加させやすいかを研究している。
また、高NA EUV露光装置は、x方向とy方向の倍率が等しくないアナモルフィックレンズを使用する。これは、他の従来の光リソグラフィと同じウェハフィールドサイズを実現するためのウェハレベルでのフィールドスティッチング(図面形成の際に2つのフィールドのふちをつなぎ合わせること)を意味する。ウェハフィールドスティッチングでは、マスクフィールドエッジの品質と可能な軽減スキームがマスクレベルでより重要になる。
さらに、マスクとEUV照明との相互作用を深く理解することの重要性が増しているため、imecでは完全なマスクR&Dエコシステムをまとめている。マスクおよびブランクのサプライヤと共に、High NA EUV Labとモデリングの両方で、新たな吸収材といったマスクのイノベーションの工業化をサポートし、マスクの複雑さ(ばらつきやステッチングなど)の軽減を検討している。
これらの問題はいずれも、高NA EUVL導入の根本的な問題ではない。ただし、最大のパフォーマンスを備えた高NA EUVLをスムーズかつタイムリーに、費用対効果の高い方法で導入するには、これらの課題に積極的に対処し、エコシステムの主要プレーヤーに効果的なコラボレーションプラットフォームを提供することが重要とimecは考えている。最初の高NA EUV露光装置を中心に据えたHigh-NA EUV Labを設立するimecとASMLの主な動機は、高NA EUVLの可能な限り迅速な導入と立ち上げの促進にある。
(次回に続く)
 |
Steven Scheer
2019年にAdvanced Patterning,Process and Materials(APPM)担当VPとしてimecに入社した後、2022年にシニアVPに昇進。責任範囲には、パターニング、ユニットプロセスおよびロジック、メモリ、フォトニクス、3D集積の新材料開発が含まれる。それ以前は東京エレクトロン(TEL)でアカウントテクノロジーディレクターを務め、米ポートランドの顧客を担当していた。TELには13年間勤務し、米国や熊本のTELの工場および東京本社R&D部門でパターニングと洗浄のR&Dを担当していた。研究キャリアは、ニューヨーク州フィッシュキルのIBMにて90/65nmのパターニング開発に取り組んだことからスタートした。テキサス大学オースチン校で化学工学分野の博士号を取得 |