半導体製造装置大手の米Applied Materials(AMAT)は、32nmと22nmのロジックおよびフラッシュメモリ製造に対応したCuバリア/シード成膜装置「Applied Endura CuBS RFX PVD」と、パッケージング工程向けPVD装置「Applied Charger UBM PVD」を発表した。
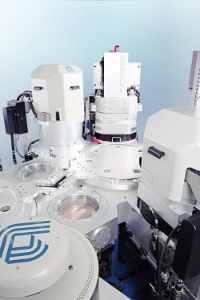
|
|
Applied CuBS RFXの外観 |
バリア/シード層の成膜は、Cuの拡散を防止するバリア層と次工程のバルクCu埋め込みに向けたCuシード層を設けるプロセス。Endura CuBS RFXに搭載されるCuシードプロセスチャンバ「EnCoRe II RFX」は、磁気軌道制御と独自のイオンフラックス制御技術により、薄膜でのカバレージ性と形状制御性の改善を実現。これにより、スムーズかつ連続なCuシード層の形成が可能となり、ボイドフリーな高いCu埋め込み特性を実現し、最適なデバイス信頼性を得ることができるようになるという。
また、ウェハ1枚あたりのコストは、競合メーカーの装置と比べて、最大で40%引き下げることが可能になるという。
一方のCharger UBMは、主にUBM(アンダーバンプメタル層)や再配線層、CMOSイメージセンサなどに向けて設計されたもので、新規に採用したリニアアーキテクチャにより、ウェハアウトプットを競合装置の2倍以上に高めているという。
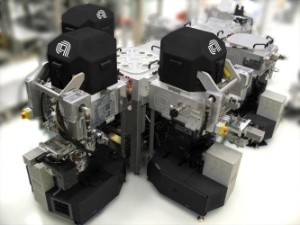
|
|
Applied Charger UBMの外観 |
また、独自のウェハトリートメント技術「Isani」の採用により、保守作業の間隔がウェハ処理枚数換算で従来比10倍に延長され、同クラスの装置において高いアップタイムを実現しながら、ウェハ1枚あたりのコストを抑えることが可能となる。
同プラットフォームは、モジュール式アーキテクチャの採用により、プロセスステーションを3基から5基まで拡張することが可能。さらに、Isaniにより、前処理を施したウェハは、形成される金属膜と下地との界面の抵抗および汚染物質濃度が低く抑えられるほか、3次元配線などの新技術にも対応できるという。