東京大学 大学院工学系研究科の鳥海明教授らは科学技術振興機構(JST)の課題解決型基礎研究の一環として、世界最高クラスの移動度を実現したGeトランジスタを開発したことを明らかにした。同技術の詳細は、2010年6月15~17日に米国ハワイ州で開催される半導体デバイスに関する国際会議「VLSI技術シンポジウム(2010 Symposium on VLSI Technology)」にて発表された。
Geトランジスタは、Siに先駆けて開発され、世界初の集積回路もGe上に作成されるなど、性能的にはSiに比べ高いものを発揮できることは知られていたが、ゲート絶縁膜を作成することがSiに比べて相当難しいという課題があった。また、その一方で、Si集積回路技術においては、その安定な絶縁膜であるSiO2の薄膜化が進み、すでに絶縁性の限界に達しており、それに替わる高誘電率ゲート絶縁膜(High-K)の研究が実用化レベルで進んでいることから、"ゲート絶縁膜には安定なシリコン酸化膜"という従来の常識から離脱することへの要請が高まっていた。
同研究グループでは、Geを用いたトランジスタの移動度の高性能化と、Ge界面の安定化を実現する指針を構築、それを実証する研究を進めてきた。結果、高い性能を実現できるGeトランジスタを実証することに成功したという。
Geと絶縁膜の界面の安定化に関して、まず、熱力学的な考察および要素的な実験を繰り返すことで、界面に起因した一酸化ゲルマニウム(GeO)の発生をいかに抑えるか、いかに安定化させるかという点に関する指導原理を構築した。GeOが発生するということは界面で二酸化ゲルマニウム(GeO2)の分解が起きることを意味し、界面を劣化させていると考えたためである。
また、Geの酸化膜であるGeO2膜は水に溶解しやすく、トランジスタを作成するプロセスで大きな支障になるため、表面は常にGeO2膜以外の材料で構成できるようにすることが必要となっていた。
このため研究チームでは、Geを酸化する際の酸素圧力を上げることで、表面におけるGeOの平衡蒸気圧を低下させ、GeOの表面からの脱離を大幅に抑制。また、Ge基板上の界面で生成したGeOが界面近くに残った場合に対して、低温における酸素熱処理を施すことで、界面におけるGeOの平衡蒸気圧を低下させることで、残留GeOを減少させた。さらにGeに比べて酸素が不足気味でも安定化物を形成する酸化物を導入することで、界面のGeOの削減に配慮。具体的には希土類金属酸化膜をGeO2中に導入することで、これを達成した。水に対する耐性がある希土類酸化膜としては、イットリウム酸化物(Y2O3)を選択した。
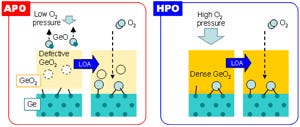
|
|
良質なゲルマニウム酸化膜の作成プロセスと、酸化過程のモデル図。APO(Atmospheric Pressure Oxidation:大気圧酸化)、HPO(High-Pressure Oxidation:高圧酸化)、LOA(Low Temperature O2 Annealing:低温酸素アニール)を表している |
これらの材料科学的なトランジスタ形成プロセス指針に加え、Geの電子の有効質量の面方位依存性を考慮し、p型(111)面Ge基板上に絶縁ゲート型電界効果トランジスタを作成したところ、約1500(cm2/Vsec)の世界最高クラスの電子移動度を持つGeトランジスタの開発に成功した。これはSiの電子移動度の約2倍にあたり、現在、しのぎを削って研究開発がなされている歪みシリコンにおける移動度上昇を超えるものとなっている。
なお研究チームでは、界面の改善あるいは歪み技術の採用によって、Geは今回の結果以上の高性能化が可能性であるとしており今後、GeのバンドギャップがSiの半分程度である性質を利用することで、低電圧でSiの性能を圧倒的に凌駕するトランジスタを開発することが可能になるとしている。