レノボ・ジャパンは、2月26日に発表された新製品「ThinkPad X300」の電気設計に関する説明会を開催した。
プレゼンテーションは同社ノートブック研究所 システム技術 基礎設計技術担当の小見山博秀氏、ノートブック研究所 システム技術 基礎設計技術 X300基板設計・EMC設計担当の小川満氏の両名によって進行された。
 |
 |
|
ノートブック研究所 システム技術 基礎設計技術担当の小見山博秀氏。「薄型に注目したThinkPad 760とパフォーマンスに特化したThinkPad T60、この2つの良いところを集めようというのがThinkPad X300のコンセプト」と紹介 |
ノートブック研究所 システム技術 基礎設計技術 X300基板設計・EMC設計担当の小川満氏 |
まず紹介されたのは回路図面の枚数。ThinkPad X300の回路図面枚数は約100ページとされる。小川氏は、はっきりとはわからないが、と前置きした上で、「一般的なノートPCであればおそらく50~70枚程度ではないか」と述べた。その内訳は、CPUが3ページ、GMCHは8ページ、ICH8は4ページ……というなか、電源に関しては20ページが割かれているとする。電源回路図面が多くなる理由は、今のチップセットは多数の電源電圧を必要としているためとのことで、電圧だけで7種類、サブ電源(パワーマネジメントのために電源を投入するようなしかけなど)を含めると30種類ほどあるのだと説明した。
次に話題は回路図面ができるより前、ThinkPad X300の回路設計段階に移った。開発をスタートする時点で行ったというのが、同社で「EPR(Execution Plan Review)」と呼ばれるデザイン・レビュー。EPRとは機種を開発するにあたり、電気設計を含む全体的な方向性、技術的課題の洗い出しと対応策などを確認する作業とされる。このEPRのほかにも社内の各分野の専門家によるレビュー、安全性に関するレビューなど様々なレビューが行われるとのことだが、「新しいチャレンジがたくさんあったThinkPad X300ではとくに詳細なレビューが行われた」という。
また、もうひとつ重要視しているのがデザインのコモナリティーという。小川氏によれば、ThinkPad X300が約100ページの回路図とされるが、例えばThinkPad T61も約100ページと、回路図はThinkPadシリーズで同じ構成をとっているのだという。これは製品間の差異を無くすことで、ひとつのプロダクトで発生した問題を全プロダクトでも修正できるといったメリットや、設計資源を独自箇所に集中させたり、テストの重点を置く箇所を明確にするといったメリットもあるとのことだ。
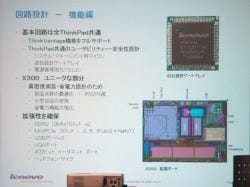 |
|
ThinkPad共通の基本回路もあれば、X300独自の部分もある。X300独自の部分とは約32%の部品点数の削減や小型部品の使用、X300専用の消費電力削減用回路など。こうしてThinkPad X300はThinkPadらしさを保ちつつ、X300オリジナルの魅力を持つ製品となっていく |
基板設計に関する説明では、X300の薄型化を可能にした2つのテクノロジが紹介された。ひとつはSantaRosa SFF(Small Form Factor)の採用、そしてもうひとつはHDI(High Density Interconnect)基板の採用とされる。まずSantaRosa SFFは、Intelのモバイル向けプラットフォーム製品のなかでも特に小型・薄型な製品に向けたパッケージだ。CPU、ノースブリッジ、サウスブリッジという3つの構成チップそれぞれが通常のStandard Packageと比べ、SFFでは60%前後に縮小されている。
HDI基板は、ThinkPad T61などでも用いられている一般的なFR4基板とは、各層の導通の構成で異なるとして紹介された。鍵となるのは2つの技術で、「ブラインド・ビア」「ベリード・ビア」の2つのビア。FR4基板での導通は、「貫通ビア」と呼ばれ、10層基板の場合、1層から10層を突き抜けるPTH(Plated Through Hole)と呼ばれるもの。HDIで用いられるブラインド・ビアは表面層とその直下の層とを接続するビアで、もうひとつのベリード・ビアは10層の場合、2層から9層までを貫通するビアとのこと。この2つのビアを用いることでより高密度実装を可能としているという。これら技術のうち、ブラインド・ビアに関しては初期のThinkPadから用いられていたとのことだ。
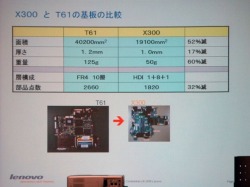 |
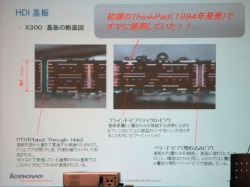 |
|
各所大きく削減されているなか、注目は層構成。T61はFR4と呼ばれる10層、X300では同じ10層でもDHIと呼ばれる1+8+1層の層構成を用いている |
特にブラインド・ビアではそのビアの上にも部品のリードをはんだ付けすることも可能とされる |
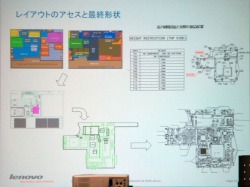 |
|
アイデアベースのThinkPad X300のレイアウトでは1スピンドルだったとのこと。プラットフォームに関しても、かなり遅い段階までSFFではなくStandard Packageで設計が進められていたとの新事実も明らかに。設計が進んでいく段階で、2スピンドルでSFFを採用していったことが伺える |
電気設計に関する最後の説明はEMCに関する内容。小見山氏は、「レギュレーションというのは、必ずしもお客様の環境を示しているものではない」と言う。そこでThinkPadシリーズでは、CISPR 22やCISPR 24といったEMC対策の国際規格に加え、IBM Standardにレノボでの基準をプラスした「Standard」、ThinkPadのノウハウに基づく独自基準「PAL」を設け、これをクリアしていくと説明した。そしてPALの一例として、今回は3点が紹介された。
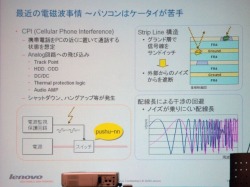 |
 |
|
ひとつはThinkPad 700シリーズの時代、パソコンに携帯電話を乗せたらカーソルが誤動作したという事例から、これを防ぐためにグランド層を設けたり、配線長の影響を調査したというもの |
ふたつ目はアースの無いノートブックPCでの静電気対策として回路を埋め込んだという |